長期以來,三星在晶圓代工領域的發展可謂屢遇波折。在先進製程技術的角逐中,儘管三星率先在3納米工藝採用GAA全環繞柵極技術,試圖彎道超車臺積電,卻因初期良率問題陷入被動。市場研究機構估算,三星製造3納米芯片的成本較臺積電高出約40%,導致高端客戶訂單流失,蘋果、英偉達等行業巨頭持續向臺積電靠攏。據TrendForce数據,2025年第一季度,臺積電全球代工市場份額高達67.6%,三星卻從上個季度的8.1%下滑至7.7%。
在製程推進上,三星原計劃2027年量產的1.4納米工藝,於2025年6月宣佈推遲至2029年,測試線建設同步暫緩。同時,德州泰勒市尖端製程晶圓廠因客戶匱乏,開業時間延遲至2026年,進一步凸顯其在先進製程市場拓展的艱難。
然而,先進製程攻堅的壓力下,三星已悄然將目光投向另一關鍵戰場。近年來,先進封裝已成爲半導體行業的戰略高地,面對晶圓代工的結構性挑戰,這家科技巨頭選擇以加碼先進封裝技術作爲突圍路徑,一系列新動作正陸續展開,爲其在半導體競爭中開闢着新的可能性。
先進封裝,三星技術突圍戰
70億美元建廠,三星搶灘美國先進封裝市場空白
在與特斯拉簽署價值165億美元的芯片代工大單後,三星迅速拋出一記重磅戰略舉措。近日,三星正式官宣,計劃豪擲70億美元在美國打造一座先進芯片封裝工廠。這一消息瞬間點燃行業關注熱情,成爲全球半導體領域熱議焦點。

上文提到,三星晶圓代工業務長期以來深陷泥沼。而特斯拉的鉅額訂單,猶如久旱逢甘霖,極大提升了三星的市值與市場信心,也爲其後續投資計劃注入了強心針,堅定了三星在美國市場進一步深耕佈局的決心。
從規劃來看,這座先進封裝工廠選址美國,精準錨定美國半導體產業當前的薄弱環節。當下,美國在芯片設計與晶圓製造環節實力強勁,擁有英偉達、高通等設計巨頭,臺積電、英特爾也在當地設有晶圓廠,但高端封裝技術卻嚴重滯後,本土尚未建成高端封裝設施。全球90%的先進封裝產能集中在亞洲,美國本土缺乏2.5D/3D堆疊、Chiplet集成等關鍵技術設施。這一產業窪地成爲三星戰略切入的核心靶點。
這座70億美元的封裝工廠將成爲三星“設計-製造-封裝”一體化模式的關鍵環節。根據規劃,工厂将聚焦高端封裝技术,與德州泰勒晶圓廠形成協同,为客户提供从芯片設計到成品交付的全流程服务。這一佈局精準卡位臺積電的時間差——台积电美国先进封裝厂最快2029年才能投產,三星若能率先落地,便能搶佔寶貴的市場先發優勢,在時間窗口上贏得先機。
值得注意的是,三星的投資節奏與訂單獲取形成聯動。在拿下特斯拉訂單十天後,其又斬獲蘋果圖像傳感器訂單,顯示出客戶對其本土化產能的迫切需求。爲規避美國關稅壁壘,從芯片製造到封裝測試的全流程本地化已成爲必然選擇,這進一步凸顯了建設本土封裝廠的緊迫性。
此外,從技術卡位角度而言,隨着半導體技術演進,先進封裝成爲提升芯片性能、實現異構集成的關鍵路徑。三星在先進封裝領域的擴展計劃劍指臺積電憑藉CoWoS技術佔據的AI芯片封裝主導地位。同時,在Chiplet生態構建上,三星通過將HBM高帶寬內存與邏輯芯片高效協同封裝,有望聯合美國芯片設計企業,打造下一代Chiplet生態,在未來芯片技術競爭中佔據有利位置。
再考慮到供應鏈佈局角度,在美國本土建立封裝產能,契合全球供應鏈本地化、安全化趨勢。三星可依託德州泰勒晶圓廠,爲客戶提供從芯片設計、製造到封裝的一站式服務,大幅縮短交付週期,提升對客戶需求的響應速度。尤其在AI芯片需求井噴的當下,美國本土封裝產能的補充,將爲英偉達、AMD等高性能計算芯片企業提供更便捷、高效的供應鏈選擇,增強三星在高端芯片市場的綜合競爭力。
政策紅利同樣不可忽視。美國《芯片與科學法案》提供的520億美元補貼中,25億美元專門投向先進封裝領域。三星的投資計劃與政策導向高度契合,有望獲得可觀補貼支持,有效降低初期投資風險。
不過,三星這一佈局並非坦途。美國建廠面臨人力、能源成本高昂難題,較韓國高出30%-40%,如何平衡成本成爲挑戰。此外,美國半導體專業人才,特別是先進封裝領域技術骨幹存在缺口,三星需妥善解決人才招募與培養問題,才能確保工廠順利運營。
總而言之,三星70億美元的美國封裝廠投資,既是對市場空白的精準卡位,也是其半導體業務戰略轉型的關鍵落子。通過填補美國產業鏈短板、整合政策資源、發揮一體化優勢,三星正試圖在先進封裝領域實現對臺積電的彎道超車。這場佈局的最終成效,不僅將影響三星自身的市場地位,更將重塑全球半導體產業的競爭格局。
三星橫濱設先進封裝研發中心
在全球半導體先進封裝技術的角逐中,三星電子再落重要一子。
近日,據行業消息人士透露,三星計劃投資250億日元(約合1.7億美元),在日本橫濱設立先進芯片封裝研發中心,此舉旨在強化其在該領域的技術實力,進一步挑戰臺積電的領先地位。
該研發中心選址橫濱港未來區的Leaf Minato Mirai大樓,這棟總建築面積達47,710平方米的12層建築(含4層地下空間)將被改造爲集研究實驗室與中試生產線於一體的研發基地,預計2027年3月正式啓用。
值得注意的是,這是三星近十年來在日本首次收購大型建築,此前其2015年曾出售東京六本木總部大樓部分股份,此次佈局凸顯了對先進封裝賽道的戰略重視。
從合作生態來看,三星的橫濱研發中心將重點深化與日本半導體產業的協同。計劃與Disco Corp、Namics Corp、Rasonac Corp等日本材料和設備供應商建立技術合作,並加強與東京大學的產學研聯動——該校距離研發中心不到一小時車程,三星計劃從中招聘大量碩士和博士級研究人員,充實研發團隊。橫濱市也將爲該項目提供25億日元的啓動補貼,爲研發中心的落地提供支持。
三星此舉也直指其在封裝領域的短板與市場機遇。
作爲芯片性能提升的關鍵技術,先進封裝通過2.5D/3D堆疊、Chiplet集成等方式,無需依賴超精細納米制程即可增強芯片功能,在AI芯片製造中至關重要。但目前三星在該領域仍落後於臺積電:Counterpoint數據顯示,2025年第一季度臺積電在代工、封裝和測試市場的總份額達35.3%,而三星僅佔5.9%,尤其在高端封裝產能和技術上差距明顯。
不過,市場增長潛力與自身突破爲三星提供了動力。先進芯片封裝市場規模預計將從2023年的345億美元增長至2032年的800億美元,而三星近期斬獲特斯拉165億美元AI6芯片訂單,被業內視爲其交鑰匙服務(代工+封裝一體化)能力提升的佐證。此次橫濱研發中心的設立,正是三星完善“設計-製造-封裝”全鏈條服務、追趕臺積電的關鍵佈局。
隨着三星在橫濱加碼先進封裝研發,全球半導體封裝市場的競爭將進一步升級。這不僅是技術層面的較量,更是產業鏈生態的比拼,而橫濱研發中心或將成爲三星縮小與臺積電差距的重要支點。
三星加碼SoP技術,挑戰臺積電SoW封裝霸權
在先進封裝技術的下一代競爭中,三星電子正全力推進“SoP(System on Panel,面板級系統)”技術的商業化落地,直接對標臺積電的SoW(System-on-Wafer,晶圓級系統)技術和英特爾的EMIB工藝,爭奪下一代數據中心級AI芯片的制高點。
三星SoP技術的核心創新在於採用415mm×510mm的超大尺寸長方形面板作爲封裝載體,這一尺寸遠超傳統12英寸晶圓(直徑300mm)的有效利用面積。傳統晶圓級封裝受限於圓形晶圓形態,最大可集成的矩形模塊尺寸約爲210mm×210mm,而三星SoP面板可輕鬆容納兩個此類模塊,甚至能生產240mm×240mm以上的超大型半導體模塊,爲超大規模AI芯片系統提供了更大的集成空間。
技術架構上,SoP省去了傳統封裝所需的印刷電路板(PCB)和硅中介層,通過精細銅重分佈層(RDL)實現芯片間的直接通信。這種設計不僅提升了集成度,還能降低封裝成本,尤其適配AI芯片和數據中心高性能計算場景的需求。三星在面板級封裝領域積累的FOPLP技術經驗,爲SoP的研發提供了堅實基礎。
商業化推進方面,三星將特斯拉第三代數據中心AI芯片系統視爲重要目標。該系統計劃集成多顆AI6芯片,初期擬採用英特爾EMIB技術生產。若三星能解決SoP面臨的邊緣翹曲、量產穩定性及高密度RDL工藝開發等難題,憑藉更大封裝面積和成本優勢,有望進入特斯拉封裝供應鏈。此外,三星同步研發的“3.3D”先進封裝技術,將進一步提升其封裝效率與成本競爭力。
此外,作爲三星的主要競爭對手,臺積電的SoW技術已進入實際應用階段。該技術基於12英寸晶圓載體,通過InFO技術擴展而來,分爲SoW-P(僅集成SoC組件)和SoW-X(集成SoC+HBM+I/O裸片)兩個平臺。其中SoW-P已投入生產,面向移動及邊緣設備;SoW-X計劃2027年投產,可集成16個高性能計算芯片和80個HBM4模塊,專爲AI/HPC場景設計,能提供高達260TB/s的die-to-die帶寬。
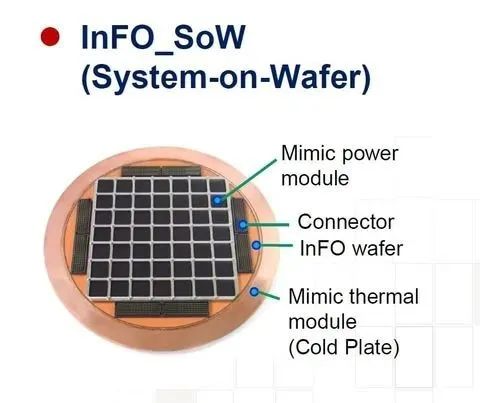
臺積電SoW技術依託成熟的晶圓製造體系,在良率控制和量產穩定性上具備優勢,目前已被特斯拉、Cerebras等企業用於超級計算芯片量產。其最新發布的SoW-X技術,通過重構晶圓設計和先進液冷策略,可支持17000W功率預算,性能較傳統計算集羣提升46%,功耗降低17%。
三星押注SoP技術,本質上是通過差異化路徑挑戰臺積電在先進封裝領域的主導地位。對三星而言,SoP的成功商業化不僅能增強其“設計-製造-封裝”一體化服務能力,更能鞏固與特斯拉等大客戶的合作——此前三星已斬獲特斯拉165億美元AI6芯片代工訂單,若SoP技術成熟,有望将封裝环节也纳入合作范围。
儘管目前SoP面臨大規模作業穩定性等技術挑戰,且超大型封裝仍屬利基市場,但三星正通過持續研發提升良率,試圖在臺積電SoW-X全面量產前搶佔市場先機,重塑先進封裝領域的競爭格局。
三星佈局玻璃基板封裝,2028年技術落地
在先進封裝技術的賽道上,三星電子還將目光投向了玻璃基板這一新興領域。
據最新消息顯示,三星已明確計劃在2028年將玻璃基板引入先進半導體封裝領域,核心目標是用玻璃中介層取代傳統硅中介層,這也是其玻璃基板技術路線圖首次正式曝光。
中介層作爲AI芯片2.5D封裝結構的關鍵組件,承擔着連接GPU與HBM內存的重要功能,直接影響芯片的數據傳輸效率。目前主流的硅中介層雖具備高速傳輸和高熱導率優勢,但材料成本高昂、製造工藝複雜,已成爲制約AI芯片降本增效的瓶頸。而玻璃中介層憑藉易實現超精細電路的特性,不僅能進一步提升半導體性能,還能顯著降低生產成本,成爲業界公認的替代方向。
三星的技術路線選擇頗具策略性。爲加快原型開發進度,其優先開發小於100×100毫米的玻璃單元,而非直接採用510×515毫米的大尺寸玻璃面板。儘管小尺寸可能影響量產效率,但能幫助三星更快完成技術驗證並切入市場。
這一決策與AMD等企業的規劃形成呼應——業界普遍預期2028年將成爲玻璃中介層規模化應用的關鍵節點。
同時,在技術落地層面,三星充分發揮集團化作戰優勢。今年3月起,三星電子已聯合三星電機、三星顯示等關聯企業共同研發玻璃基板技術:三星電機貢獻半導體與基板結合的專有技術,三星顯示則提供玻璃工藝支持,形成跨領域技術協同。近期技術人才的加盟,進一步強化了其在該領域的研發實力。
產線佈局上,三星計劃將外部合作企業提供的玻璃中介層,與天安園區現有的面板級封裝(PLP)生產線結合進行封裝作業。PLP技術作爲在方形面板上完成封裝的工藝,相比傳統晶圓級封裝(WLP)具有更高的生產效率,且與玻璃基板的方形特性高度適配,爲玻璃中介層的量產提供了現成的製造基礎。
三星此舉直指AI時代的封裝需求痛點。在去年的晶圓代工論壇上,三星已提出涵蓋晶圓代工、HBM和先進封裝的一站式AI解決方案戰略,而玻璃基板技術的加入將進一步完善這一體系。通過引入玻璃中介層,三星既能提升封裝環節的性能與成本優勢,又能與自身的HBM內存、先進製程代工業務形成協同,增強對AI芯片客戶的綜合服務能力。
值得注意的是,三星的玻璃基板策略與行業對手形成差異化。其並未盲目追求大尺寸面板技術,而是通過小單元快速驗證、集團資源協同、現有產線複用的組合策略,穩步推進技術落地。這一務實路徑不僅降低了技術風險,更凸顯了三星在先進封裝領域“多點突破、持續迭代”的整體佈局思路。隨着2028年落地節點的臨近,玻璃基板或將成爲三星挑戰封裝技術制高點的又一重要籌碼。
佈局Fan-Out PKG,移動AI芯片的關鍵支撐
在移動AI技術快速發展的背景下,封裝技術需在高性能、低功耗與緊湊設計之間找到精準平衡。三星的扇出型封裝(Fan-Out PKG)技術憑藉靈活架構與高效性能,成爲移動AI芯片的關鍵支撐方案。

扇出型封裝技術自2023年起已應用於移動 AP(應用處理器)量產,其核心採用芯片後裝和雙面重分佈層(RDL)的FOWLP(扇出晶圓級封裝)技術。
相比傳統封裝方案,該技術實現了多維度提升:工藝週轉時間縮短33%,大幅提升生產效率;架構設計更具靈活性,可適配不同移動設備的定製化需求;熱阻降低45%,顯著增強散熱能力,有效解決了移動設備緊湊空間內的散熱難題。
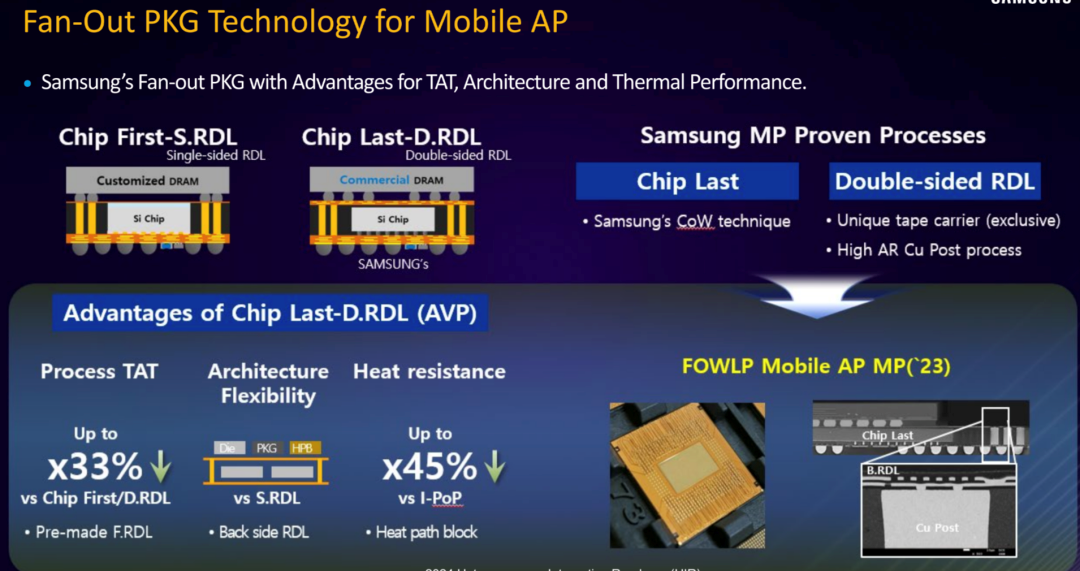
針對移動AI對低功耗寬I/O內存的需求,三星進一步推出多芯片堆疊FOPKG技術。通過採用高縱橫比銅柱(AR>6:1)和精細間距RDL設計,该技術实现了I/O密度提升8倍、帶寬提高2.6倍的性能飛躍,同时生产率较传统垂直引线键合技術提升9倍,在提升性能的同時兼顧了量產經濟性。
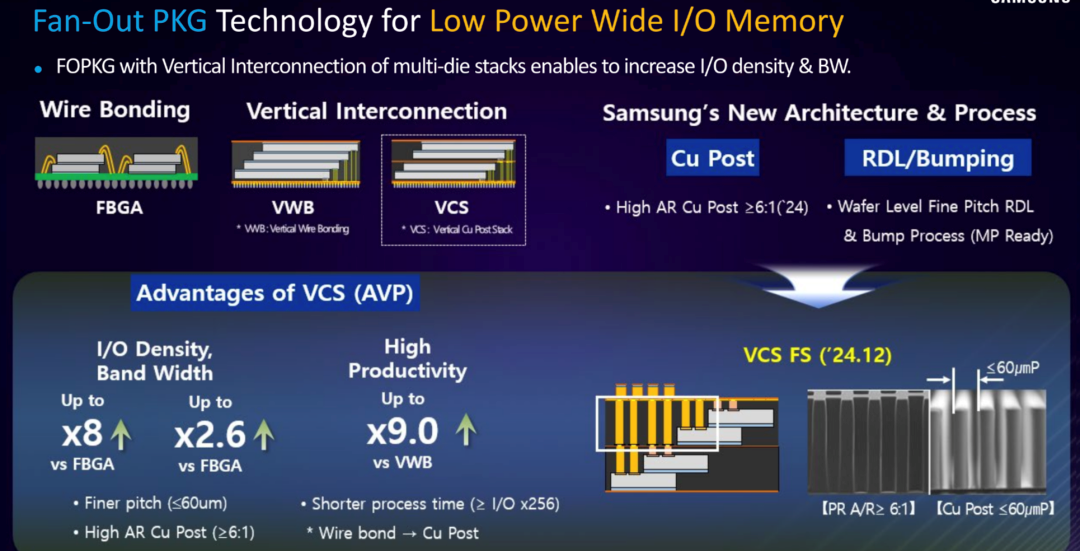
不過,扇出型封裝在移動設備應用中仍面臨獨特挑戰。移動設備對功耗和散熱的高敏感性,要求技術在高密度互連中解決材料匹配問題——例如不同材料熱膨脹係數(CTE)的不一致可能導致應力累積,影響封裝可靠性。
此外,隨着移動AI算力需求的持續增長,扇出型封裝的擴展性仍需優化。對此,三星正通過材料創新(如研發低CTE基板)和模塊化設計,進一步提升技術對多樣化移動場景的適應性。
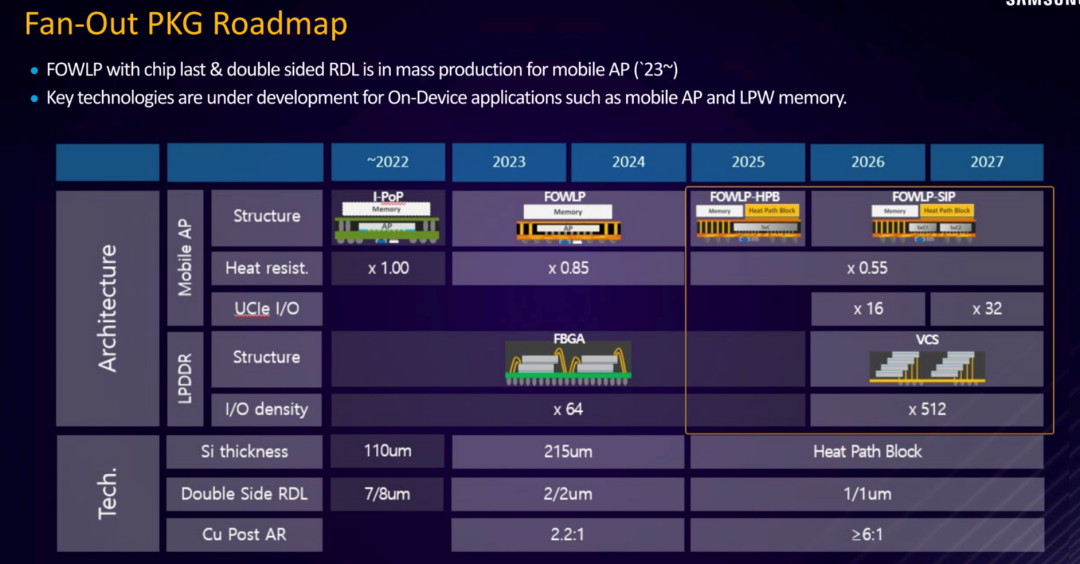
作爲三星異構集成生態系統的重要組成部分,扇出型封裝與HBM、3D邏輯堆疊、I-Cube等技術形成協同,共同推動移動AI芯片的性能突破。
未來,通過持續提升堆疊層數、優化間距設計和擴大中介層尺寸,三星扇出型封裝技術有望在解決散熱瓶頸、工藝複雜性和成本控制等挑戰的過程中,繼續引領移動AI封裝領域的技術演進。
三星SAINT技術:存儲與邏輯協同封裝的創新突破
在先進封裝技術的佈局中,三星電子還推出了SAINT(三星先進互連技術)體系,聚焦存儲與邏輯芯片的協同封裝,通過創新3D堆疊技術構建差異化競爭力。
SAINT技術體系涵蓋三種針對性的3D堆疊方案,分別適配不同芯片類型的集成需求:
SAINT-S:專爲SRAM設計的堆疊技術,優化靜態隨機存取存儲器的集成效率;
SAINT-L:面向邏輯芯片的堆疊方案,提升邏輯電路的垂直集成密度;
SAINT-D:針對HBM內存與邏輯芯片的協同設計,採用垂直堆疊架構,將HBM芯片直接堆疊在CPU或GPU等處理器頂部。
其中,SAINT-D技術最具創新性,徹底改變了傳統2.5D封裝中通過硅中介層水平連接HBM與GPU的模式。它採用熱壓鍵合(TCB)工藝實現HBM的12層垂直堆疊,成功消除了對硅中介層的依賴,不僅簡化了結構,更帶來顯著性能提升:熱阻較傳統工藝降低35%,良率達到85%。
這一技術爲HBM內存與邏輯芯片的高效協同奠定了基礎,2025年三星憑藉該技術已佔據全球25%的HBM產能份額。不過,垂直堆疊方案也對HBM內存基片的製造工藝提出了更高要求,需要開發更復雜的基片生產技術。
爲支撐SAINT技術的落地與量產,三星同步推進全球封裝設施佈局。在韓國本土,三星與忠清南道天安市簽訂協議,計劃建設佔地28萬平方米的先進 HBM 封裝工廠,預計2027年完工;在日本橫濱,三星正在建設Advanced Packaging Lab(APL)研發中心,重點攻關下一代封裝技術,聚焦HBM、人工智能和5G等高價值芯片應用的封裝創新。
通過SAINT技術體系的構建,三星進一步強化了存儲與邏輯芯片的協同封裝能力,爲AI、高性能計算等領域提供了更高效率、更低功耗的集成解決方案,也爲其在先进封装赛道的竞争增添了关键筹码。
三星I-Cube與X-Cube先進封裝技術
在先進封裝技術的競爭格局中,三星電子構建了以I-Cube和X-Cube爲核心的技術體系,分別覆蓋2.5D和3D IC封裝領域。通過與臺積電、英特爾等對手的技術對比,可更清晰把握三星在該領域的定位與特色。
三星的I-Cube技術聚焦2.5D封裝領域,細分爲I-Cube S、I-Cube E以及衍生的H-Cube三種方案,通過不同的中介層設計滿足多樣化需求。
Cube S:高帶寬硅中介層方案
I-Cube S採用硅中介層(Silicon Interposer)作爲核心連接載體,將邏輯芯片與高帶寬存儲器(HBM)裸片水平集成在同一中介層上,實現高算力、高帶寬數據傳輸與低延遲特性。
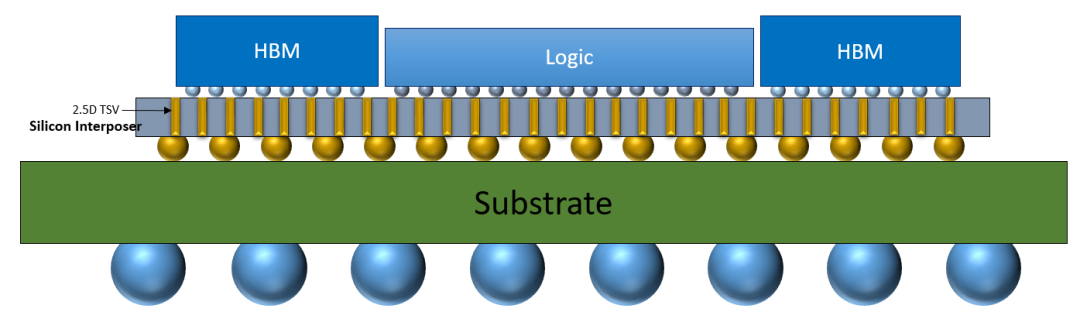
其技術優勢體現在三大方面:一是在大尺寸中介層下仍能保持出色的翹曲控制能力;二是具備超低信號損失和高存儲密度特性;三是顯著優化了熱效率控制。從結構上看,I-Cube S與臺積電的CoWoS-S技術相似,均採用“芯片-硅轉接板-基板”的三層架構,適用於對性能要求嚴苛的高端AI芯片場景。
Cube E:嵌入式硅橋創新設計
與I-Cube S的整體硅轉接板不同,I-Cube E採用“嵌入式硅橋(Embedded Silicon Bridge)+RDL中介層”的混合架構:在高密度互連區域部署硅橋以實現精細布線,其餘區域則通過無硅通孔(TSV)結構的RDL中介層完成连接。
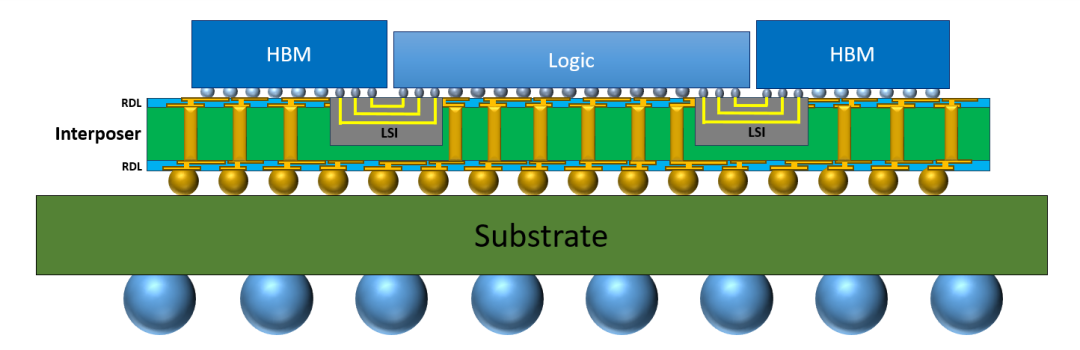
這種設計既保留了硅橋的精細成像優勢,又發揮了RDL中介層在大尺寸封裝中的靈活性。該技術與臺積電的CoWoS-L架構相近,均借鑑了英特爾EMIB技術的核心思路,在平衡性能與成本方面更具優勢。
H-Cube:混合基板過渡方案
H-Cube是I-Cube系列的衍生技術,採用“硅中介層-ABF基板-HDI基板”的混合結構。通過將精細成像的ABF基板與高密度互連(HDI)基板結合,H-Cube可支持更大的封裝尺寸,佈線密度較基礎版I-Cube S進一步提升。
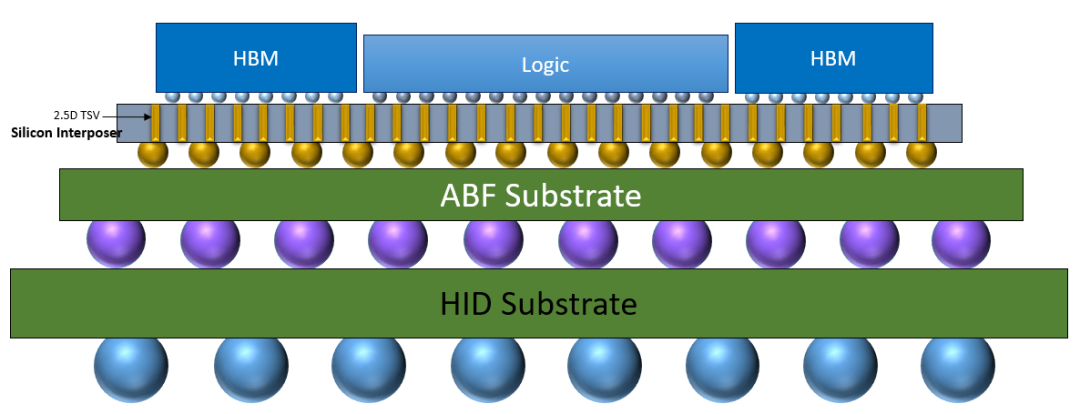
不過從技術演進來看,H-Cube更偏向過渡性方案——隨着HDI基板佈線能力的提升,ABF基板的中間層未來可能被省略,因此三星未將其作爲獨立技術類別,而是歸入I-Cube體系下。
3D IC突破:X-Cube垂直集成技術
X-Cube是三星面向3D IC封裝的核心技術,通過硅通孔(TSV)實現芯片間的垂直電氣連接,顯著提升系統集成度。根據界面連接方式的不同,X-Cube分爲兩種類型:
X-Cube (bump):採用凸點(bump)連接上下芯片界面,技術成熟度高,適合對成本敏感的中高端應用。
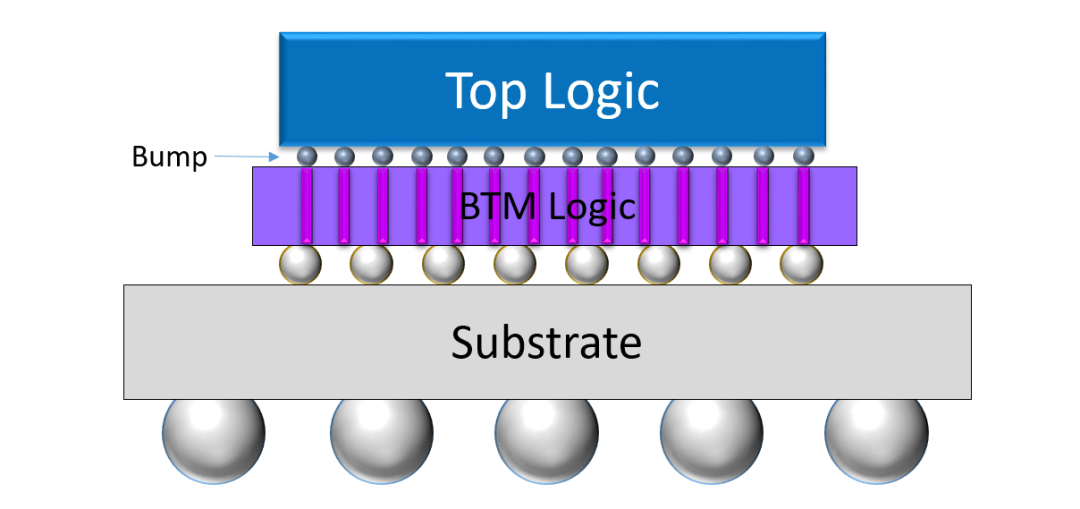
X-Cube (Hybrid Bonding):採用混合鍵合技術實現界面連接,可大幅提升互連密度和熱傳導效率,是面向未來的高性能方案。
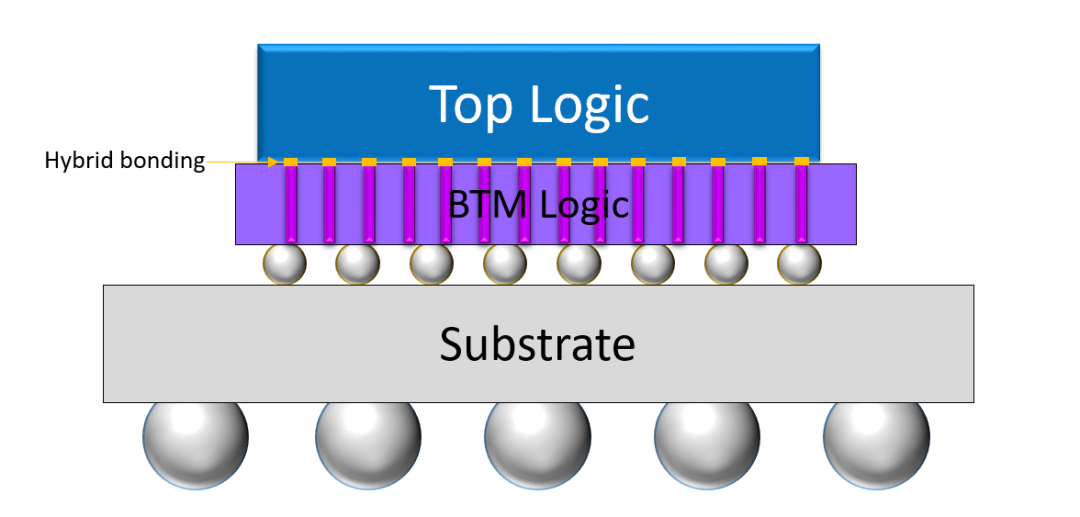
兩種方案結構框架一致,核心差異在於連接精度與性能表現,共同構成三星在3D封裝領域的技術儲備。
整體而言,與臺積電作爲純代工廠的技術輸出模式不同,三星和英特爾的先進封裝技術更多服務於自身芯片產品,因此市場知名度相對較低。
在技術路線上,三星目前更多扮演跟隨者角色,I-Cube和X-Cube系列與臺積電產品存在較多相似性。若想實現趕超,三星需在技術差異化和生態建設上加大投入。不過,先進封裝作爲半導體產業的“朝陽賽道”,技術成熟度仍有巨大提升空間,三星憑藉其在存儲芯片與晶圓製造領域的協同優勢,未來有望在該領域實現突破。
寫在最後
在晶圓代工業務承壓的背景下,三星將先進封裝視爲戰略突圍的核心方向,通過多維度佈局構建競爭壁壘。
從70億美元押注美國封裝工廠搶佔市場空白,到日本橫濱研發中心深化技術協同;從推进SoP面板級封裝挑戰臺積電SoW霸權;再到規劃2028年玻璃基板技術落地,Fan-Out PKG支撐移動AI,SAINT體系強化存儲與邏輯協同,以及I-Cube與X-Cube覆蓋2.5D/3D封裝場景,三星形成了“技術研發+產能落地+生態協同”的立體佈局。
三星致力於通過差異化技術路徑彌補先進製程短板,依託“設計-製造-封裝”一體化能力爭奪AI、數據中心等高端市場,同時藉助美國政策紅利與本土化供應鏈鞏固客戶合作。儘管面臨成本高企、良率優化等挑戰,但三星憑藉集團資源協同與技術迭代韌性,正逐步縮小與頭部玩家的差距。
展望未來,隨着各項技術的成熟落地,三星有望在先進封裝這一戰略高地實現突破,重塑全球半導體產業的競爭格局。
本文來源微信公衆號“半導體行業觀察”,FOREXBNB編輯:陳秋達。








